为适应灵巧型便携式电子产品发展的要求,美国国家半导体公司于1999年开发出目前尺寸最小的焊球形微表面贴装器件封装技术(Bump micro SMD package technology),简称微SMD封装。应用这种技术在1999年3季度推出了最小封装尺寸的时基电路、运算放大器及音频功率放大器等一批新器件。
焊球形微表面贴装器件封装有两个特点:1.采用大规模或超大规模器件的BGA封装技术,为缩小器件的面积,将引脚做成焊球形排列在方形或矩形器件的底面,焊球引脚的间距为0.5mm,但其引脚数仅4~8个,8引脚的如图1所示;2.它与一般封装不同,没有塑料、陶瓷或金属材料的外壳,而是在硅片的底面做出焊球(引脚),在上面加一块环氧树脂组成的盖板而成,因此它也称为管芯(Chip)尺寸封装。焊球引脚由铅锡合金组成(锡63%、铅37%)。
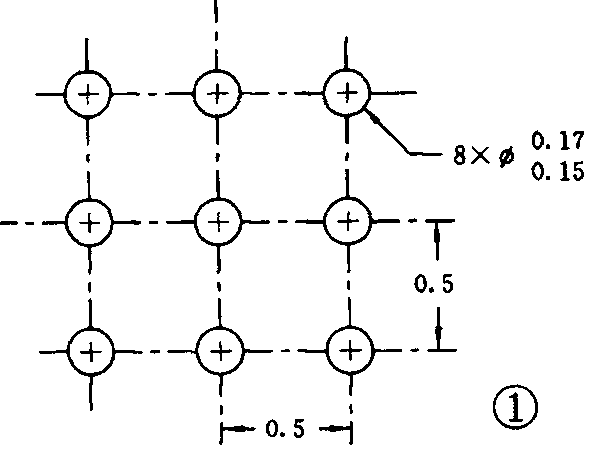
在盖板上印有日期代码及器件代码,并有引脚起始标记(左下角),一种双运放器件的代码如图2所示。

焊球形微表面贴装器件封装的外廓尺寸并不统一而是与器件的引脚多少及器件的内部复杂程度有关,分别用X1、X2、X3表示宽、长、高尺寸。现有的器件有4~8个引脚,某一种8引脚的排列及外廓尺寸如图3所示(其外廓尺寸因器件内部结构不同而不同,但引脚间的排列及间距尺寸是一样的)。
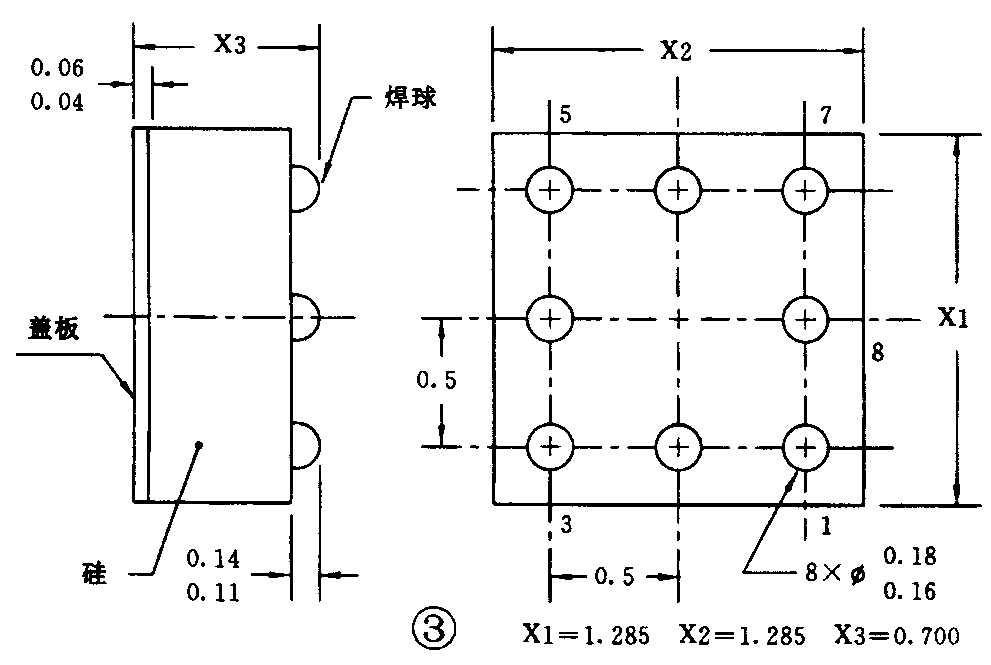
从图1及图3可以看出用这种封装的器件尺寸极小,其面积比一颗芝麻粒还小。用8引脚焊球形微表面贴装器件封装尺寸与8-SOP及SOT-23-8封装作一个比较如附表所示。若以8引脚的新型封装的LM158双运放的面积为1,SOT-23A的面积为它的4.84倍;而采用8-SOP封装时,其面积比它大19.5倍。

采用这种新型封装的新器件不仅仅在封装尺寸比SO封装、SOT-23或SC-70封装小了很多,在器件性能上也有较大的改进。采用这种封装的器件互连线路较短,寄生电容、电感非常小,也不会有信号的衰减,从而提高了高频性能。
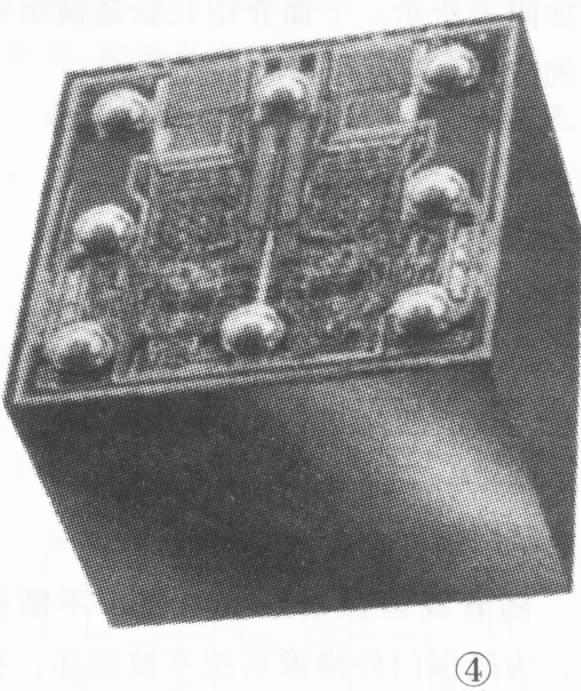
8脚微SMD封装器件的外形照片见图4。(戴维德)