(金国钧)晶体三极管简称为晶体管。外形和电路图中的符号见图1。

晶体管的基本结构
一块半导体材料分成三部分:两边是P型半导体中间是N型半导体,或者两边是N型半导体中间是P型半导体。前一种是PNP型晶体管(锗管3A系列,硅管3C系列,都是PNP型),后一种是NPN型晶体管(锗管3B系列,硅管3D系列,都是NPN型晶体管)。它们的基本结构见图2。

从图2可以看出,晶体管是由两个PN结构成。晶体管的导电分析
以下的说明,以NPN型晶体管为例。
晶体管电源连接方式,一般都是使发射结正向连接,收集结反向连接(如图3所示)。此外,基区做得很薄,基区导电率比发射区低很多,也就是说基区载流子极少。集电区与发射区虽然是同一类型的半导体,但导电率也不相同。因此,晶体管各个管脚不能弄错。
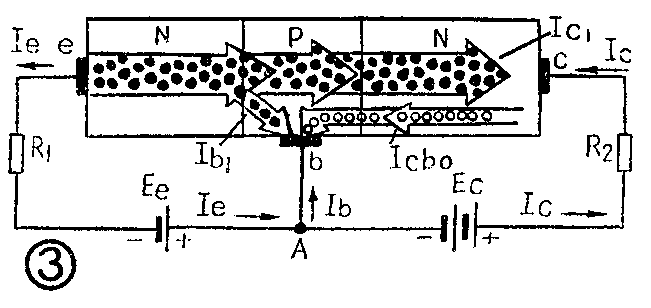
电源接通后,发射结在正向电场作用下,多数载流子(电子)的扩散运动加强。收集结在反向电场作用下,少数载流子(空穴)的漂移运动加强。(参阅本刊1973年第2期《PN》结一文)
从发射区扩散到基区的电子,到达基区后,由于基区靠发射区一边电子浓度较大,靠集电区一边电子浓度较小,所以继续向集电区方向扩散。收集结加的是反向电场,向收集结方向运动的电子是逆电场方向的,所以受到拉力,加速流向集电区。上面已说过,基区做得极薄,而且载流子极少,因此,在这种情况下,从发射极扩散来的电子大部分很快进入集电区,只有极少一部分在基区与空穴复合(即电子进入空穴)。
从发射区扩散进入基区的电子,不断从发射极电源得到补充,形成发射极电流I\(_{e}\)。
基区的多数载流子(空穴)也要向发射区扩散,但由于基区载流子很少,可以忽略不计。从发射区扩散来的电子,大部分进入集电区,形成电流l\(_{cbo}\)只有很少一部分在基区与空穴复合。由于基区接电源正极,可以不断从电源中补充复合了的空穴,形成电流Ib1。
收集结加的是反向电压,所以基区、集电区之间少数载流子的漂移运动加强。由于基区载流子很少,少数载流子(电子)更少,所以漂移运动主要是集电区的少数载流子(空穴)流向基区,如图3小箭头所示。漂移运动形成的电流叫做I\(_{cbo}\),即“集电极反向饱和电流”。Icbo的数值很小,而且与外加电压的大小关系不大,所以叫饱和电流。
从图3可以看出,基区复合电流是电子流。漂移电流是空穴流。由于电流方向规定得与电子流方向相反,而与空穴流的方向相同,所以I\(_{b1}\)的方向与Icbo的方向相反,而I\(_{c1}\)的方向与Icbo的方向相同。因此,基极电流I\(_{b}\)=Ib1-I\(_{cbo}\),集电极电流Ic=I\(_{c1}\)+Icbo。
从以上分析可以看出,I\(_{c}\)与Ib比较,I\(_{c}\)很大,Ib很小。而且,由于晶体管制成后基区厚度已定,材料也定下来了,所以I\(_{c}\)与Ib在相当大的一个范围内总维持一个固定的比例关系。
从晶体管外电路看,例如从图3中A点看,由于A点不能存储电流,流入A点的电流必须等于从A点流出的电流,所以I\(_{e}\)=Ib+I\(_{c}\)。
由于I\(_{c}\)与Ib有一定的比例关系,而且I\(_{e}\)=Ib+I\(_{c}\),所以晶体管起一种电流分配器的作用,把发射极电流Ie按一定比例关系分成I\(_{c}\)和Ib,而且I\(_{c}\)远大于Ib。由于存在这种分配关系,所以只要使I\(_{b}\)略为增加(例如加大发射结正向电压),Ic就要增加很多,比I\(_{b}\)增加的量大很多倍。晶体管能够放大,就是利用这个特点。
为了从数量上说明,可以按图4电路连接方式,测量I\(_{e}\)、Ib、I\(_{c}\)的数值。每改变一次R,测一次Ie、I\(_{b}\)、Ic。测得的数值列成下表(表中数值是测3BX\(_{1}\)得出的)。

从表中可以看出,I\(_{b}\)从0.04增加到0.09时,Ic从0.96增加到1.91。I\(_{b}\)的增加量为0.09-0.04=0.05。Ic的增加量为1.91-0.96=0.95。这两个增加量的比值为0.950.05=19。也就是说I\(_{c}\)的增加量为Ib的增加量的19倍。也可以说,I\(_{c}\)的变化把Ib的变化放大到19倍。
Ie(毫安) 1 2 3 4 5
Ic(毫安) 0.96 1.91 2.86 3.81 4.7
Ib(毫安) 0.04 0.09 0.41 0.19 0.24
如果把图4中的R换成一个信号源,如图5所示。很明显,I\(_{b}\)随信号源的电压变化而变化,Ic也变化,而且I\(_{c}\)的变化把Ib的变化放大很多倍。这样,就可以通过晶体管放大信号,做成放大器。

晶体管的参数
晶体管的参数,就是说明晶体管特性的数据。设计晶体管电路,选用晶体管,都要以这些数据作依据。晶体管参数有几种体系,名目繁多。这里只介绍几种主要的参数。
电流放大系数。在静态情况下,也就是在外加电压不变化的情况下,晶体管的电流放大系数,就是I\(_{c}\)与Ib的比值。一般用符号β-代表(β为希腊字母,念作“贝塔”)。因此,β-=\(\frac{I}{_{c}}\)Ib
在动态情况下,也就是在接有交流信号源的情况下,电流放大系数为晶体管集电极电流I\(_{c}\)的变化量与基极电流Ib的变化量的比值。一般用符号Δ(Δ为希腊字母,念作“德尔塔”)代表变化量,所以I\(_{c}\)的变化量可用ΔIc表示,I\(_{b}\)的变化量可用ΔIb表示。β代表动态电流放大系数。因此,β=\(\frac{I}{_{c}}\)Ib
晶体管的β值,在I\(_{c}\)很小(例如几十微安)时,或者在Ic很大(接近规定的最大工作电流)时,都比较小,但在I\(_{c}\)=1毫安以上相当大的范围内,小功率管的β值都比较大,而且基本上数值不变。一般晶体管的β值在20至100之间。 β-与β的数值近似,在估算时,常用β-代替β。
集电极反向饱和电流I\(_{cbo}\)。Icbo上面已说过,是集电区到基区的漂移电流。I\(_{cbo}\)受温度影响大。在室温情况下,小功率锗管的Icbo约为10微安左右,硅管的I\(_{cbo}\)小于1激安。
I\(_{cbo}\)的大小,标志晶体管的质量。良好的晶体管,Icbo应当很小。
穿透电流I\(_{ceo}\)。穿透电流Iceo是在基极开路的情况下,发射结加正向电压、收集结加反向电压时流过晶体管的电流。
从图6可以看出、发射极接电源负极、集电极接电源正极时,由于U\(_{c}\)>Ub>U\(_{e}\),所以收集结加的是反向电压,发射结加的是正向电压(图中十一号标示的是外加电压的极性)。收集结漂移运动加强,集电区的少数载流子(N型材料为空穴)向基区漂移,形成的电流即Icbo基区由于载流子极少,少数载流子(P型材料为电子)更少,可以忽略不计。发射结扩散运动加强,发射区电子向基区扩散,在基区的情况与上节《晶体管导电分析》中说的相似:大部分通过基区进入集电区,只有少部分在基区与空穴复合。由于基极开路,没有基极电流,I\(_{b}\)=0。因此,在基区参与复合的电子与从集电区漂移过来的空穴数量应相同。上面已说过,从集电区漂移来的空穴形成电流Icbo,所以参与复合的电子流也应等于I\(_{cbo}\),这样,才能满足Ib=0的条件。因此,从发射区扩散的电子,不断从电源得到补充,形成发射极电流,在图6中发射极电流即I\(_{ceo}\)。这个电流经过基极后,留下与漂移电流Icbo相等的一部分,其余进入集电区。按照晶体管电流分配的原则,进入集电区的部分与留在基区的部分有一定的比例关系,这两部分的比值,即β值。所以进入集电区的部分即为βI\(_{cbo}\)。在集电区,Icbo是空穴流,βI\(_{cbo}\)是电子流,它们形成的电流方向相同(注意:电流方向规定为电子流的反向,而为空穴流的同向),所以集电极电流为βIcbo+I\(_{cbo}\)。这样,相当于Iceo在基区留下一个I\(_{cbo}\)部分,在集电区又加上一个Icbo部分,又恢复I\(_{ceo}\)原来的数量,因此集电极电流等于Iceo=βI\(_{cbo}\)+Icbo,或者I\(_{ceo}\)=(1+β)Icbo。

穿透电流也是表示晶体管质量的参数。I\(_{ceo}\)是Icbo的(1十β)倍,影响比I\(_{cbo}\)更大些。良好的晶体管,Iceo应当很小。
极限参数。极限参数,就是为保证晶体管正常工作而规定的最大容许数据。
1.集电极最大容许电流I\(_{cm}\)。上面说过,集电极电流Ic超过一定数值后,β显著减小。I\(_{cm}\)就是根据这个数值规定的。
2.集电极一发射极击穿电压BU\(_{ceo}\)。在基极开路时,允许加在集电极与发射极之间的最大电压。如果超过这个电压,晶体管就要击穿损坏。
3.集电极一基极反向击穿电压BU\(_{cbo}\)。在发射极开路时,允许加在集电极一基极间的最大反向电压。超过这个电压,收集结将击穿,损坏晶体管。
4. 集电极最大耗散功率P\(_{cm}\)。集电极电流,在晶体管内要产生热量。如果这个热量不散掉,温度就会升高。温度升高后,影响半导体的导电性能,超过一定温度后会破坏晶体管的正常工作。为了保证晶体管正常工作,就要规定晶体管产生的热量,不超过一定数值。一般不直接规定热量数值,而是规定功率数值。因为功率与热有一定比例关系。功率一般用P表示,等于电流I(单位为安)乘以电压U(单位为伏),即P=IU,单位为瓦。晶体管功率一般很小,用瓦作单位太大,所以采用千分之一瓦(即毫瓦)作单位。例如3DG4型晶体管的集电极最大耗散功率Pcm规定为300毫瓦。