WLCSP──全新内存封装技术
硬件周刊
近日ACE(Advanced Chip Engineering)宣布将采用WLCSP(Wafer-Level Chip-Scale Package)技术来制造256MB的DDR内存。ACE组织就WLCSP技术已经在台湾及美国申请了五项专利。目前也有不少内存厂家,如Nanya、Oki和Casio等厂家都就WLCSP技术和ACE进行过商讨。因为333MHz的DDR即将在今年内存市场崭露头角,专家预测在2003年它会进入主流市场。但传统的TSOP(Thin Small Outline Package)封装技术已经不能满足333MHz或更高工作频率内存的要求。因此必须改进封装技术,虽然MiniBGA、μBGA(Micro BGA)和WLCSP都值得考虑。但只有WLCSP的成本最为低廉,也是最成熟的新封装技术之一。
一、初识WLCSP
近年来流行的一些高级电子设备,如蜂窝电话、笔记本电脑、掌上电脑PDA和其他一些便携式的电子设备都需要非常精巧的高密度封装技术。传统的集成电路封装结构基本都是通过金属导线在垫片与核心之间连接+电极在外的树脂封装结构。而当前流行的集成电路封装技术则是DIP(Dual Inline Package)双重线内封装和QFP(Quad Flat Package)四面封装技术。然而增加封装周围的针脚会缩短导线长度,并且这种封装的芯片有一定局限性。而芯片水平的晶圆封装技术,可以在我们使用多年的球形栅格阵列(BGA)在工艺上实现密集的电极栅格结构。WLCSP之所以成为一个发展比较迅速且具有开创性的技术,就是因为减小了芯片封装体积,此外还可以降低生产成本。
二、WLCSP结构
WLCSP一项崭新的发展观念就是在焊接剂的作用下,形成一个被铜和有弹性的树脂覆盖的芯片。实现方法如(图2)的交叉架构所示。利用同样的电镀方法,使两个铜片覆盖在树脂的核心上。而这样的工作要实行两次才可以满足再度分配的原则。同时,信息拥挤的部分自动选择后分配给信息稀疏的地方。于是低信息的地方开始有大量工作,高带宽的地方将分配给更加需要信息处理的部件,阻抗余下的部分将平均分开成若干等待处理的新信息。因此,它可以达到窄带分批处理信息、宽带直接处理信息的效果。WL-CSP是一个有25针的封装芯片。具体数据如下表所示:(图1)

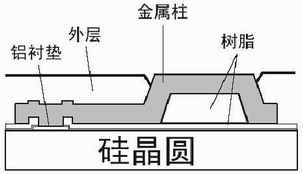
三、WLCSP制作过程
如(图2)所示的硅晶圆是怎么生产出来的呢?我们可以通过示意(图3)来看它的制作过程。
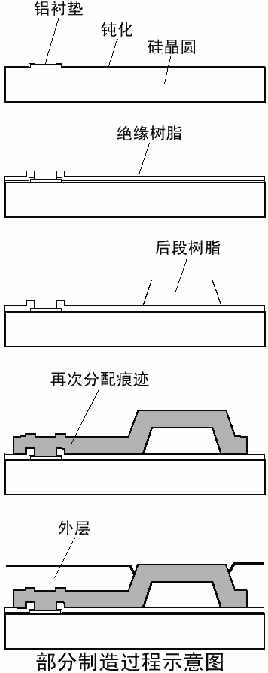
在(图3)中,先在晶片表面上涂上一层感光树脂,此时,厚度仅为1微米的铝垫就成为作业系统和恢复系统。第二层感光树脂将指令发给第一层感光树脂,完成了一次作业,表示厚度为3微米的第二层感光树脂重复了一次作业。
为了让铜层取得更好的组合效果,铜层被设计在了核心的交叉部分,铜层的边不能与基本平面平行,然后再用厚度为20微米的特殊镍金物质分三次覆盖在铜层的根部,最后将它再次电镀在树脂核心上。
(图4)是最终的成品芯片图。
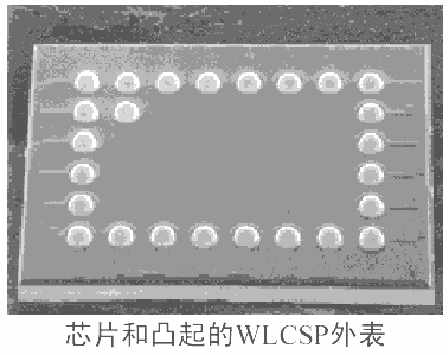
四、WLCSP的稳定性能
WLCSP技术是铜电气性能良好运用的典范,从WLCSP的连接和隔离装置中,我们可以看出它的设计具有良好的传导性。而且WLCSP这个有金属覆盖的树脂层的新设计,与传统工艺相比只需要1/5的电镀铜以及很少的相应金属加工过程。WLCSP的稳定性一般要经过高压测试、高温存储测试、温度周期变化测试和热循环测试。经过这样一系列的严格测试之后,才能证明所封装的芯片稳定性是一流的,由此可见WLCSP对封装技术的苛刻要求。在早期的发展过程中,WLCSP封装芯片的第一层感光树脂层里曾经出现一些问题。估计是因为受到重力的影响导致绝缘和树脂保护外层失效。这些问题已经随着WLCSP的进一步研究和开发解决了。
五、总结
WLCSP是一种新的有特色的晶圆级芯片封装技术,随着金属树脂覆盖层这一技术的推广,以后它将会有更大的发展和应用空间。它可以减少芯片的封装体积和封装成本,使芯片变得更薄更小。WLCSP技术的大面积推广,可以提高我们的生产工艺和减少生产费用。随着厂商对这项技术的发展和研究,我们将会找到更合适的廉价树脂材料,从而在我们未来的集成电路生产制造过程中使成本更加低廉。